Студентам > Курсовые > Развитие технологии МОП ИС
Развитие технологии МОП ИССтраница: 7/7
Ещё одной причиной, мешающей дальнейшему уменьшению размеров транзисторов, является квантово - механическая природа инверсионного слоя, которая не позволяет электронам располагаться непосредственно у поверхности кремния. Максимум пространственного распределения электронов находится на расстоянии около 1 нм от поверхности. Это увеличивает эффективную толщину окисла примерно на 0,3 нм. Кроме того, вследствие ограниченной концентрации примеси в поликремниевом затворе в нём наступает режим обеднения, из-за которого увеличивается эффективная толщина подзатворного слоя диэлектрика. Общее увеличение эффективной толщины составляет около 0,7 нм, что уменьшает ток стока и нагрузочную способность транзистора.
В экспериментах с приборами, имеющими толщину окисла 1,3–1,5 нм, было обнаружено, что туннельный ток через подзатворный диэлектрик может быть существенно уменьшен путём повышения однородности плёнки окисла. Для получения однородной плёнки в работе использовано селективное эпитаксиальное наращивание нелегированного кремния для получения канала МОП - транзистора, поскольку плёнка окисла на эпитаксиально выращенном кремнии получается более однородной. Для получения канала сначала была выполнена ионная имплантация бора в область канала для n - канального транзистора и фосфора для р - канального. Затем из газовой фазы был выращен эпитаксиальный слой нелегированного кремния толщиной от 5 до 20 нм. Благодаря предварительному легированию кремния был получен практически идеальный ретроградный профиль примеси в эпитаксиальном слое. После этого была получена тонкая (1,5 нм) плёнка окисла путём окисления эпитаксиального слоя в сухом кислороде. Затвор был выполнен не из поликремния, как обычно, а из TiN. Зернистость TiN примерно в три раза меньше, чем у поликремния, что улучшило однородность диэлектрика под затвором.
Ключевым моментом техпроцесса для длин канала менее 100 нм является получение мелких (менее 20 нм) p-n-переходов. Однако они дают неприемлемо высокое сопротивление областей истока и стока. Для его снижения обычно используют промежуточный слой из TiSi2 или CoSi2, рис. 5.6. После формирования слоя подзатворного окисла толщиной 4,6 нм формируется поликремниевый затвор с помощью электронно-лучевой литографии. Между затвором и областями локального окисления оставляется пространство 0,35 мкм для формирования областей истока и стока. Боковые стенки поликремниевого затвора защищаются тонким (10–20 нм) слоем Si3N4 для отделения затвора от контактов к истоку и стоку. После этого выполняется селективное эпитаксиальное наращивание слоя SiGe толщиной 50 нм, легированного фосфором. Далее формируют второй защитный слой на боковых стенках поликремниевого затвора, который является маской для последующей имплантации областей истока и стока. При последующей диффузии фосфора из нанесённого ранее слоя SiGe формируются мелкие слаболегированные области истока и стока. Контакты к истоку, стоку и затвору выполняют селективным наращиванием вольфрама. Полученная таким образом структура показана на рис. 5.6. Часть эпитаксиального слоя, находящаяся поверх мелких областей истока и стока, понижает их омическое сопротивление.
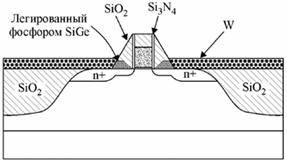
Рисунок 5.6 - МОП - структура, в которой мелкие области истока и стока получены диффузией из легированного фосфором SiGe 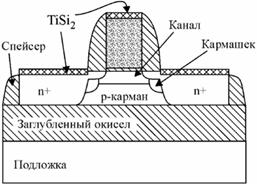
Рисунок 5.7 - КНИ – структура с длиной канала 0,28 мкм и шириной 9,1 мкм
Список использованных источников
1. Интегральные схемы на МОП – приборах. Пер с англ. / Под ред. А. Н. Карамзинского. - М. : Мир , 1975 г.
2. А. П. Бурманов. Физические основы технологии микроэлектроники.
3. Особенности субмикронных МОП - транзисторов: Режим доступа: [http://www.chipinfo.ru/literature/chipnews/200207/4.html]
4. Р. Мелен, Г. Гарланд. ИС с КМОП структурами, 1979 г.
5. И. А. Малышева. Технология производства ИС, 2002 г.
6. Г. Я. Красников. Конструктивно – технологические особенности субмикронных МОП – транзисторов, 2004 г.
7. Технология СБИС. Кн. 1 и Кн. 2 : В 2 кн. / Пирс К. , Адамс А. , Кац Л. и др. ; Под ред. Чистякова Ю. Д. - М. : Мир , 1986.
8. Березин, Андрей Сергеевич
9. Технология и конструирование интегральных микросхем : [учебное пособие для вузов по спец. "Физика и технология материалов и компонентов электрон. техники" и "Микроэлектроника и полупроводниковые приборы"] / Березин А. С., Мочалкина О. Р. - М. : Радио и связь , 1992.
Copyright © Radioland. Все права защищены.
Дата публикации: 2008-04-09 (0 Прочтено) | 
 Главная
Главная
 Схемы
Схемы
 Студентам
Студентам
 Программы
Программы
 Поиск
Поиск
 Top50
Top50

 Главная
Главная
 Схемы
Схемы
 Студентам
Студентам
 Программы
Программы
 Поиск
Поиск
 Top50
Top50